半导体制程封装“银烧结技术(LTJT)”的详解;
发布时间:2024-09-18
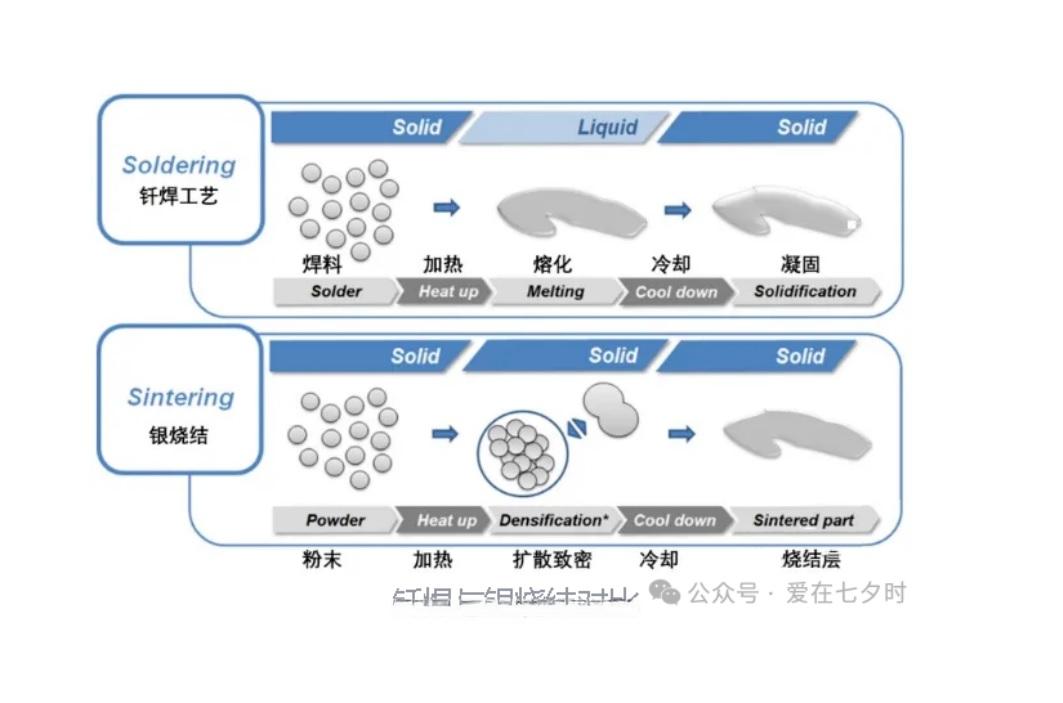
银烧结技术正在成为半导体封装领域的一颗新星。这种低温烧结技术通过将纳米级银颗粒在300℃以下进行烧结,形成具有优异导电和导热性能的连接层,为功率模块封装提供了革命性的解决方案。
与传统的焊料技术相比,银烧结技术展现出显著优势。首先,银烧结连接层的熔点高达961℃,远高于传统焊料的300℃以下熔点,这意味着它能在更高的温度下保持稳定,不会出现典型的疲劳效应。其次,银烧结技术能在低温条件下(<250℃)获得耐高温(>700℃)和高导热率(~240 W/m·K)的烧结银芯片连接界面。这使得它特别适合用于高温SiC器件等宽禁带半导体功率模块的芯片互连。
银烧结技术的原理是通过原子间的扩散实现良好连接。以纳米银浆为例,烧结过程中银颗粒通过接触形成烧结颈,银原子通过扩散迁移到烧结颈区域,最终形成连续的孔隙网络。这种多孔性结构的孔洞尺寸在微米及亚微米级别,具有良好的导热和导电性能。
在功率模块封装中,银烧结技术的应用已经取得了显著成果。2006年,英飞凌采用银烧结技术的功率模块进行了高温循环测试。结果显示,采用单面银烧结技术的模块寿命比传统软钎焊工艺模块提高了5~10倍,而采用双面银烧结技术的模块寿命更是提高了10倍以上。2012年,英飞凌推出的.XT封装连接技术采用了扩散焊接工艺,实现了从芯片到散热器的可靠热连接。
赛米控在2007年推出的SKiNTER技术,利用精细银粉在高压及约250°C温度条件下烧结为低气孔率的银层,使功率循环能力提升了2~3倍。2015年,三菱电机采用银烧结技术制作的功率模块,循环寿命是软钎焊料的5倍左右。
随着第三代半导体器件(如碳化硅和氮化镓等)的快速发展,对封装性能提出了更为严苛的要求。银烧结技术凭借其高可靠性、高导热性和耐高温特性,正成为解决这些挑战的关键技术。特别是在高温功率电子领域,银烧结技术的应用前景广阔。
然而,银烧结技术的发展也面临着一些挑战。例如,早期的烧结过程需要较大的辅助压力(约40MPa),这可能会对芯片造成损伤,并增加经济成本。但随着研究的深入,纳米银烧结技术的出现解决了这一问题。纳米银材料的熔点和烧结温度均低于微米银,连接温度可低于200℃,辅助压力可降至1-5MPa,同时仍能保持较高的耐热温度和导热导电能力。
随着半导体技术的不断进步,银烧结技术有望在更广泛的领域发挥作用。从智能手机、智能家居到智能汽车,银烧结技术将为这些行业带来更高性能、更可靠的半导体产品,推动智能制造实现更快速、更有效的发展。未来,我们有理由相信,银烧结技术将在半导体封装领域扮演越来越重要的角色,为电子产业的发展注入新的活力。